介紹一種COB軟基模塊及其電子標簽
廣東省RFID電子標簽卡封裝工程技術(shù)研究開發(fā)中心
在RFID系統(tǒng)中,從智能卡或標簽天線與RFID芯片的電氣互連上,廣泛采用的方法是Flip Chip(即芯片倒封裝)技術(shù),將裸芯片直接倒封裝在柔性天線的端部。但是多種多樣的天線結(jié)構(gòu)和多規(guī)格或不同應用的RFID芯片,在實際倒封裝技術(shù)中,由于目前集成電路倒封裝設備存在靈活性較差,無法適應與各種規(guī)格尺寸的電子標簽天線之間的互聯(lián),且標簽天線與芯片連接天線端之間的最佳阻抗匹配存在一定的差異。故而要實現(xiàn)柔性基材大批量、較佳性能匹配、高效率的生產(chǎn),以及更有效地優(yōu)化生產(chǎn)成本,唯有采用創(chuàng)新工藝進行天線與芯片的互連,從而實現(xiàn)較佳的匹配增益,這也正是目前整個RFID行業(yè)內(nèi)都在研究的熱點問題之一。
傳統(tǒng)的RFID智能卡或者電子標簽產(chǎn)品的生產(chǎn)模式,會隨著市場需求變化而受到越來越多的各種制約和挑戰(zhàn)。尤其是當市場多元化需求的變化達到某一個量時,從芯片封裝的角度來講,怎樣才能及時按質(zhì)、按量,快速完成各項訂單,是任何一個芯片封裝廠商都不可忽視的現(xiàn)實問題。因此,傳統(tǒng)意義上的芯片封裝形式及其智能卡的生產(chǎn)模式已經(jīng)遠遠不能滿足市場的實際需要。
在采用RFID應用系統(tǒng)的電子標簽中,主要有感應天線部件和集成電路微芯片核心部件。集成電路芯片采用COB模塊的封裝形式,仍然是當前的主流封裝形式之一。一般而言,COB模塊封裝大抵分為PCB(印刷線路板)邦定封裝(硬基形式)和鍵合倒封裝(軟基形式)這兩大類。前述兩大類又可分為若干細化分類,本文將要介紹的軟基COB模塊就是鍵合倒封裝形式中的一種。
預先將RFID芯片采用特殊高密度鍵合倒封裝工藝,制作成為單獨的COB軟基模塊,可以有效的提高產(chǎn)品的良品率,使得RFID產(chǎn)品的電氣性能進一步增強。根據(jù)不同芯片的COB模塊封裝,可以有多種不同的COB排列組合。將不同數(shù)量的RFID芯片設置在一大版軟基材上,通過高密度鍵合倒裝處理技術(shù),得到一大版完整的COB模組。制作好的COB軟基模塊可以根據(jù)不同的生產(chǎn)需要,任意配合不同尺寸和不同性能的RFID天線,完成不同外觀以及適合不同場合使用需要的RFID電子標簽產(chǎn)品。
軟基模塊、模組的特征 采用軟基鍵合倒封裝形式,大多會將RFID微晶片的外接天線端直接連接在制作好的蝕刻天線兩端。這樣做的好處是,制作周期短,工藝簡單。但對于那些有特別需求的客戶,這種方法會有一定的局限性。比如,客戶或系統(tǒng)集成商自己設計制作好了天線,僅需對相應的芯片進行倒封裝時,那么,在芯片與天線的連接處理精度上,就會有一定的偏差,甚至于不匹配。
為此,采用軟基COB模塊的形式,就可較為理想的解決這個問題。附圖1是本文介紹的軟基COB模塊的單體示意圖。從圖中可以看出,1代表軟基COB模塊,2是RFID微晶片,3和4分別表示軟基COB模塊的兩個延伸連接端子,5和6表示芯片和延伸連接端子之間的鍵合倒裝凸點。附圖2為本文介紹的軟基COB模塊整版的局部示意圖。
采用軟基COB模塊的特點是:
▲將標簽天線和標簽芯片分為兩個軟基組件單獨制作,使得產(chǎn)品的靈活性、可靠性增強;
▲預先倒封裝工藝的一致性好;
▲COB軟基模塊的整體架構(gòu)簡單,過程易于控制;
▲可以靈活搭配不同的標簽天線,從而滿足不同客戶的個性化需求;
▲模組集成了一定數(shù)量的軟基模塊,適合規(guī)模化生產(chǎn),提高了生產(chǎn)效率;
▲標準的軟基模塊化設計,配用不同尺寸的RFID天線,可以使電子標簽產(chǎn)品系列化、多樣化;
▲剔除傳統(tǒng)COB模塊滴黑膠固化工藝,既降低了COB軟基模塊的厚度,同時也降低了產(chǎn)品的成本;
▲軟基COB的厚度很薄,有利于生產(chǎn)出更加超薄的RFID產(chǎn)品。
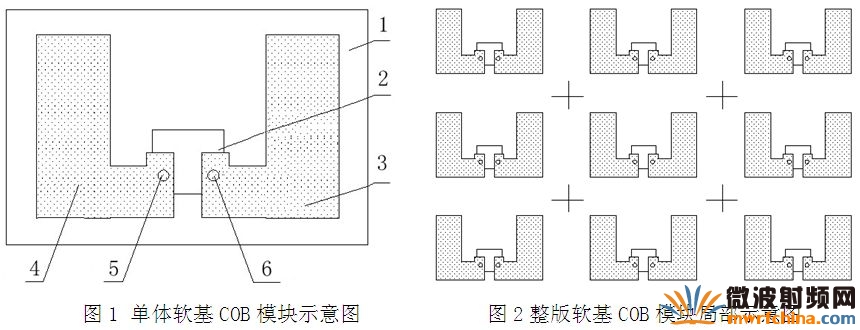
之所以采用軟基COB模組的方式,主意是為了克服傳統(tǒng)倒封裝工藝無法滿足市場對RFID電子標簽產(chǎn)品高性能與多品種量產(chǎn)過程一致性較差的問題。為了更有效地降低生產(chǎn)成本和提高產(chǎn)品的規(guī)模化產(chǎn)能,采用拆分二元結(jié)構(gòu)模塊化預封裝模式,將RFID芯片與軟基天線的封裝工藝,分為兩個互相獨立的二元組件結(jié)構(gòu)。這種二元組件結(jié)構(gòu)的工藝技術(shù),可以很好的克服傳統(tǒng)倒封裝工藝在RFID電子標簽多品種量產(chǎn)時所存在的一些不足之處。
為此,將承載RFID標簽天線的大塊軟基和承載RFID芯片的橋接小塊軟基分開制造,采取預先在橋接小塊軟基上完成RFID芯片的對位、貼裝和引導金屬線路之間的互連,形成一個小塊軟基COB模塊后,再與預先已經(jīng)設計和調(diào)試優(yōu)化好的大塊軟基天線通過橋聯(lián)沖貼的方式,完成芯片和天線之間的電氣連接,從而可以通過不同天線與不同芯片的組合,快速實現(xiàn)電子標簽對天線多規(guī)格、IC芯片多品種、多功能的電氣性能搭配,滿足更多不同場合的應用。
模塊、模組的典型應用 參照以上附圖,將單體軟基COB模塊嵌入到實際的應用中,而使其成為質(zhì)量過硬、可以經(jīng)受市場考驗的產(chǎn)品,才是最終目的。附圖3所示的就是具體的實例之一。應用中的COB軟基模塊和標簽天線的連接處有一小部份會處于疊合狀態(tài),這種疊合的重合部份通過橋聯(lián)沖貼的工藝方式,在完成軟基COB模塊和標簽天線電路間的電氣聯(lián)通之后,即成為標準的Inlay(即標簽芯料),也就是RFID電子標簽的半成品。給這個半成品“穿上一件外衣”,就成為了一張標準的RFID電子標簽卡。
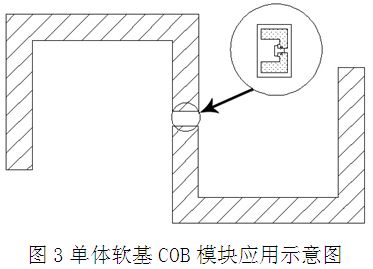
當然,附圖3所示的僅僅是本文介紹的軟基COB模塊在UHF頻段中的一種普通應用。實際上,目前除了不能應用在LF(125 kHz -134.2kHz)頻段之外,在HF(13.56MHz)頻段,軟基COB模塊同樣有非常出色的表現(xiàn)。
結(jié)束語 本文所介紹的軟基COB封裝工藝,只是RFID行業(yè)眾多封裝工藝中的一種。相信RFID的封裝技術(shù)會隨著電子標簽不斷廣泛的實際應用,其封裝工藝也會不斷的推陳出新。不管采取什么樣的封裝形式和工藝,其目的都是為了合理節(jié)約成本、努力提高產(chǎn)品質(zhì)量。
放眼各行各業(yè),“沒有最好,只有更好”是一條永恒不變的真理,無論過去、現(xiàn)在,還是將來,我們愿意與所有熱愛并從事RFID行業(yè)的人們一起攜手,相互學習,銳意進取,共同創(chuàng)造RFID行業(yè)的美好明天。

 粵公網(wǎng)安備 44030902003195號
粵公網(wǎng)安備 44030902003195號